Electronic Components and Technology Conference (ECTC) est un rendez-vous international incontournable pour la recherche, la technologie et la formation dans les domaines de l’intégration (3D integration & packaging) de composants et de systèmes microélectroniques ou photonique. Lors de l’édition 2023 (juin 2023, USA), deux études menées dans le cadre de Nanoelec ont été présentées par des scientifiques du CEA :
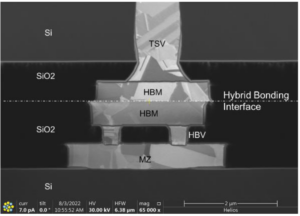
Collage hybride Cu-Cu pour des applications d’intégration 3D : Un véhicule de test à deux couches face-arrière (F2B) a été réalisé en combinant la technologie de collage hybride Cu-Cu à faible pas avec des TSV à haute densité. Trois structures empilées différentes, construites sur des plaquettes de silicium au standard industriel de 300 mm de diamètre, sont nécessaires pour réaliser ce véhicule d’essai. Des caractérisations morphologiques ont été effectuées et ont mis en évidence l’intégrité de la structure 3D : les dimensions des TSV HD sont de 1 μm de diamètre et de 10 μm de hauteur.

TSV à haute densité pour les capteurs d’image CMOS à 3 couches. Un rapport d’aspect de 10:1 a été visé avec un diamètre/espace de 1 μm/1 μm (pas de 2 μm) associé à une profondeur de 10 μm. Un véhicule d’essai constitué d’un seul niveau métallique de chaque côté d’un substrat Si aminci collé sur un support épais a été utilisé pour développer et optimiser un processus compatible avec les contraintes d’un processus de collage hybride ultérieur. Une résistance électrique de 0,7 Ω (valeur médiane) a été mesurée sur les motifs Kelvin et un rendement de 100 % a été obtenu sur une série composées de 10 000 TSV. Du point de vue de la fiabilité thermique, aucune défaillance n’a été observée après 2000 h à 150 °C ni après 2000 cycles entre -55 °C et +150 °C.
Dans le cadre de Nanoelec, le CEA-Leti a développé une technologie de collage hybride qui permet une meilleure interconnexion des circuits intégrés et trouve des applications dans divers domaines tels que le calcul haute performance et les dispositifs photoniques. Lire ici.
